对新型微电子封装技术发展的思考
随着表面安装技术的迅速发展,新的封装技术不断出现,微电子封装技术成了现代封装的热门话题。本文叙述了微电子三级封装的概念,并对发展我国新型微电子封装技术提出了一些思考。
一、微电子三级封装
谈到微电子封装,首先我们要叙述一下三级封装的概念。一般说来,微电子封装分为三级。所谓一级封装就是在半导体圆片裂片以后,将一个或多个集成电路芯片用适宜的封装形式封装起来,并使芯片的焊区与封装的外引脚用引线键合(WB)、载带自动键合(TAB)和倒装芯片键合(FCB)连接起来,使之成为有实用功能的电子元器件或组件。一级封装包括单芯片组件(SCM)和多芯片组件(MCM)两大类,也称芯片级封装。二级封装就是将一级微电子封装产品连同无源元件一同安装到印制板或其它基板上,成为部件或整机,也称板级封装。三级封装就是将二级封装的产品通过选层、互连插座或柔性电路板与母板连结起来,形成三维立体封装,构成完整的整机系统,也称系统级封装。所谓微电子封装是个整体的概念,包括了从一极封装到三极封装的全部技术内容。在国际上,微电子封装是一个很广泛的概念,包含组装和封装的多项内容。微电子封装所包含的范围应包括单芯片封装(SCM)设计和制造、多芯片封装(MCM)设计和制造、芯片后封装工艺、各种封装基板设计和制造、芯片互连与组装、封装总体电性能、机械性能、热性能和可靠性设计、封装材料、封装工模夹具以及绿色封装等多项内容。
二、微电子封装技术的发展
(一)焊球阵列封装(BGA)
BGA主要有四种基本类型:PBGA、CBGA、CCGA和TBGA,一般都是在封装体的底部连接着作为I/O引出端的焊球阵列。这些封装的焊球阵列典型的间距为1.0mm、1.27mm、1.5mm,焊球的铅锡组份常见的主要有63Sn/37Pb和90Pb/10Sn两种,焊球的直径由于目前没有这方面相应的标准而各个公司不尽相同。从BGA的组装技术方面来看,BGA有着比QFP器件更优越的特点,其主要体现在BGA器件对于贴装精度的要求不太严格,理论上讲,在焊接回流过程中,即使焊球相对于焊盘的偏移量达50%之多,也会由于焊料的表面张力作用而使器件位置得以自动校正,这种情况经实验证明是相当明显的。其次,BGA不再存在类似QFP之类器件的引脚变形问题,而且BGA还具有相对QFP等器件较良好的共面性,其引出端间距与QFP相比要大得多,可以明显减少因焊膏印刷缺陷导致焊点“桥接”的问题;另外,BGA还有良好的电性能和热特性,以及较高的互联密度。BGA的主要缺点在于焊点的检测和返修都比较困难,对焊点的可靠性要求比较严格,使得BGA器件在很多领域的应用中受到限制。
(二)芯片尺寸封装(CSP)
CSP的定义是LSI芯片封装面积小于或等于LSI芯面积的20%的封装称为CSP。
由于许多CSP采用BGA的形式,所以最近两年封装界权威人士认为焊球节距大于等于1mm的为BGA,小于1mm的为CSP。由于CSP具有更突出的优点①近似芯片尺寸的超小型封装②保护裸芯片③电、热性优良④封装密度高⑤便于测试和老化⑥便于焊接、安装和修整更换。由于CSP正在处于蓬勃发展阶段,因此,它的种类有限多如刚性基板CSP柔性基板CSP、引线框架型CSP、微小模塑型CSP、焊区阵列CSP、微型BGA、凸点芯片载体(BCC)、QFN型CSP、芯片迭层型CSP和圆片级CSP(WLCSP)等.CSP的引脚节距一般在1.0mm以下,有1.0mm、0.8mm、 0.65mm、0.5mm、0.4mm、0.3mm和0.25mm等。
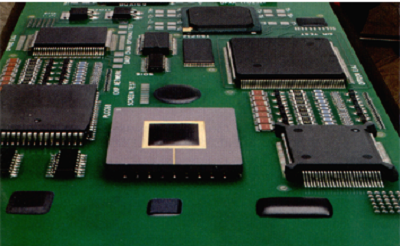
(三)系统封装(SIP)
实现电子整机系统的功能,通常有两个途径。一种是系统级芯片(SystemonChip),简称SOC。即在单一的芯片上实现电子整机系统的功能;另一种是系统级封装(Systeminpackage),简称SIP。即通过封装来实现整机系统的功能。从学术上讲,这是两条技术路线,就象单片集成电路和混合集成电路一样,各有各的优势,各有各的应用市场。在技术上和应用上都是相互补充的关系,作者认为,SOC应主要用于应用周期较长的高性能产品,而SIP主要用于应用周期较短的消费类产品。
SIP是使用成熟的组装和互连技术,把各种集成电路如CMOS电路、GaAs电路、SiGe电路或者光电子器件、MEMS器件以及各类无源元件如电容、电感等集成到一个封装体内,实现整机系统的功能。主要的优点包括①采用现有商用元器件,制造成本较低②产品进人市场的周期短③无论设计和工艺,有较大的灵活性④把不同类型的电路和元件集成在一起,相对容易实现。美国佐治亚理工学院PRC研究开发的单级集成模块简称SLIM,就是SIP的典型代表,该项目完成后,在封装效率、性能和可靠性方面提高10倍,尺寸和成本较大下降。到2010年预期达到的目标包括热密度达到100W/cm2;元件密度达到5000/cm2;I/O密度达到3000/cm2.
尽管SIP还是一种新技术,目前尚不成熟,但仍然是一个有发展前景的技术,尤其在中国,可能是一个发展整机系统的捷径。
三、思考
面对世界蓬勃发展的微电子封装形势,分析我国目前的现状,我们必须深思一些问题。
(一)微电子封装与电子产品密不可分,已经成为制约电子产品乃至系统发展的核心技术,是电子行业先进制造技术之一,谁掌握了它,谁就将掌握电子产品和系统的未来。
(二)微电子封装必须与时俱进才能发展。国际微电子封装的历史证明了这一点。我国微电子封装如何与时俱进当务之急是研究我国微电子封装的发展战略,制订发展规划。二是优化我国微电子封装的科研生产体系。三是积极倡导和大力发展属于我国自主知识产权的原创技术。
(三)高度重视微电子三级封装的垂直集成。我们应该以电子系统为龙头,牵动一级、二级和三级封装,方能占领市场,提高经济效益,不断发展。我们曾倡议把手机和雷达作为技术平台发展我国的微电子封装,就是出于这种考虑。
(四)高度重视不同领域和技术的交叉及融合。不同材料的交叉和融合产生新的材料不同技术交叉和融合产生新的技术不同领域的交叉和融合产生新的领域。技术领域已涉及电子电路、电子封装、表面贴装、电子装联、电子材料、电子专用设备、电子焊接和电子电镀等。我们应该充分发挥电子学会各分会的作用,积极组织这种技术交流。
作者:郭志伟 来源:数字化用户 2014年13期
